私たちのサービスが必要な理由は、プロジェクトが適切に行われ、機能することを確認するための専門知識と経験を持つ、高度な資格を持つ専門家を獲得していることを知っているからです。

AlN チャネルを備えたダイオードとトランジスタは、高い降伏電圧と信じられないほどの高温での動作を実現します。
多くの人間活動が極限環境にまで拡大しており、その動機は資源の搾取が多いです。これにより、地下深部、海上、深宇宙など、さまざまな方向への探査が行われてきました。これらすべての環境では温度が極端に高く、金星の表面、深井戸掘削、作動中のエンジン内部の空間では 300°C を超えます。
これらすべての環境についてさらに詳しく知るには、センサーの導入が必要です。しかし、最も明白なもの、つまりシリコンをベースにしたものは、動作温度限界が比較的低いため、その役割を果たしません。つまり、これらの環境から私たちの生活を豊かにするためには、極温度エレクトロニクスを開発する必要があるということです。
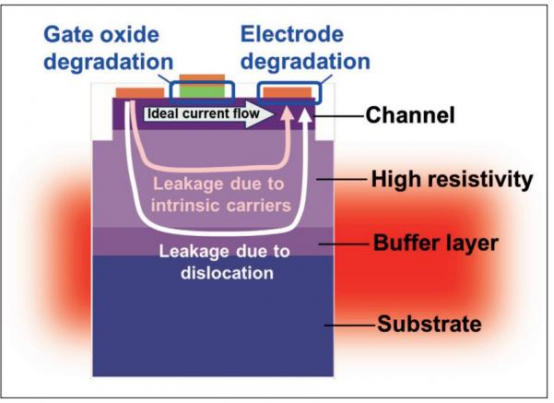
図 1. ゲート酸化膜を備えた MESFET のリーク電流経路と熱劣化点。
あらゆる形態の半導体デバイスが極端な温度で動作すると、材料、電極、ゲート酸化物、パッケージングに関連する問題に直面します (図 1 を参照)。温度が上昇すると、価電子帯の最大値から伝導帯の最小値までの電子の励起により、多数の電子-正孔対が生成されます。これらの電子は真性キャリア濃度を増加させますが (図 2 (a) を参照)、デバイスのリーク電流を増加させ、デバイスのターンオフを妨げるため、有害です。リーク電流を低減するためのオプションには、バンドギャップ エネルギーが大きく真性キャリア濃度が低い半導体材料を導入すること (図 2 (b) を参照)、チャネル以外の領域からの電流拡散を制限することなどがあります。実効ドナー/アクセプタ濃度と欠陥濃度が低い高抵抗層で囲まれたチャネル層に目を向けると、デバイスの動作温度が上昇する可能性があります。別のアプローチは、JFET や BJT などの p-n 接合を備えたデバイスを展開することです。このような場合、ベース半導体との反応性が最小限に抑えられる高融点金属を電極に選択することも重要です。特に、チタン、バナジウム、タンタル、モリブデン、タングステン、プラチナは、アルミニウム、マグネシウム、銅、銀、インジウム、金よりもこの目的に適しています。
AlN を使用する理由
シリコンよりも大きなバンドギャップエネルギーを持つ半導体材料は数多くあります。これらには、SiC (3.3 eV)、GaN (3.4 eV)、Ga が含まれます。2O3 (4.7-5.2 eV)、ダイヤモンド(5.5 eV)、AlN(6.1 eV)。 Philip Neudeck 率いる NASA のチームは、SiC JFET が 800°C 以上の温度でも動作できることを報告しました。これは間違いなく素晴らしい結果ですが、さらに広いバンドギャップを持つ材料はさらに高い温度に達することが期待されます。ただし、それらのかなりの数には重大な欠点があります。 GaN は 10 という高い実効ドナー濃度に悩まされます。16 cm-3; p型Gaを形成することは不可能です2O3 層。ダイヤモンドは700℃付近で酸素と反応し始めます。まったく対照的に、AlN には明らかな欠陥がなく、熱安定性と制御可能なドーピングが備わっています。これらの特性により、筑波大学の私たちのチームは、極温度デバイスの開発のために AlN に全力を注いできました。
歴史的に、AlN は絶縁体としてのみ優れていると考えられてきました。しかし、約 20 年前、NTT の谷安義隆氏らは、MOCVD によって導電性 AlN 層を成長させることによって、これが当てはまらないことを実証しました。
このチームは 426 cm の電子移動度を記録しました2 V-1 s-1 シリコンドープ AlN 層の場合、ドーパント濃度 3 x 1017 cm-3。この研究に基づいて、彼らは p 型 AlN 成長の先駆者となり、波長 210 nm の最初の AlN LED と準垂直 AlN p-n ダイオードを実証しました。これらの成功は、AlGaN および AlN をベースとした深紫外 LED の最近の急速な開発のおかげです。
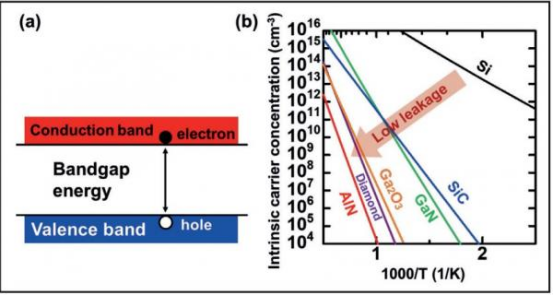
図 2. (a) 高温での電子正孔対の生成の図。 (b) 逆数温度の関数としてのシリコン、SiC、GaN、β-Ga2O3 ダイヤモンド、および AlN の真性キャリア濃度。
光学デバイスと同様に、研究コミュニティは、高臨界電場の潜在的な利点を探るために、AlN ショットキー バリア ダイオードと AlN/AlGaN HEMT を研究してきました。残念ながら、これらのデバイスは、ドナーとアクセプターのイオン化エネルギーが高いため、キャリア濃度が低くなります。シリコンでは 0.3 eV、マグネシウムでは 0.6 eV です。このため、これらのドーパントのキャリア濃度はそれらの濃度よりも約 2 桁低くなり、デバイスの電流が非常に小さくなります。この問題を克服するために、私たちのチームはMITおよびアアルト大学の研究者と協力して、N極性AlGaN/AlN構造に分極誘起ドーピングを導入することで新境地を開拓しました。自発分極と圧電分極のおかげで、この形式のドーピングにより電流が増加し、接触抵抗率が低下します。分極誘起ドーピングを使用して、ドレイン電流が 100 mA mm-1 を超える初の N 極性 AlN ベースの PolFET および HEMT を実証しました。このような成功により、私たちは AlN を光学および電気デバイス用の実用的な半導体とみなすようになりました。
これらのデバイスを製造するために、私たちは多くの材料サプライヤーを活用することができました。 2 インチのサファイア基板上の高品質 AlN サンプルは Dowa Electronics Materials から購入でき、2 インチのバルク AlN は Stanley および旭化成から市販されています。

図 3. (a) 1600°C でアニールした後の、厚さ 3 μm のシリコン注入 AlN 層内のシリコン、酸素、炭素の不純物濃度の深さプロファイル。 (b) アニーリング後の、厚さ 1 μm のマグネシウムが注入された AlN 層内のマグネシウム濃度の深さプロファイル。
AlNのドーピング
半導体内のドーパント濃度の制御には、結晶成長中の不純物の取り込み、熱拡散、場合によっては注入が含まれます。後者は魅力的な技術であり、正確な線量制御を可能にし、ドーパントの横方向の高い均一性を保証します。しかし、高線量の注入が使用されると、結晶格子が損傷し、キャリアを補償する可能性がある高濃度の点欠陥が導入される傾向があります。幸いなことに、この損傷のほとんどは、シリコン注入された n 型 AlN チャネルを製造するときに使用したポストサーマル アニーリングで修復できます。
表面を含む AlN 結晶の印象的な特徴の 1 つは、高温での堅牢性であり、窒素ガス下で 1700 °C までの安定性を備えています。この堅牢性により、注入損傷を修復するための広い範囲が提供されます。このプロセスでは、シリコン注入された AlN 層の電気的活性化に 1200°C 以上の温度が必要です。ただし、アニーリング温度を選択する際には、材料の他の変化を引き起こす可能性があるため、十分な考慮が必要であることに注意してください。 1400°C を超えると、シリコンと酸素の不純物が上の層内に拡散します。窒素ガス下で1500℃で分解するサファイア基板からの酸素原子の拡散により、高温アニール後にサファイア基板上の薄いAlN層の酸素濃度が高くなり、電気特性の劣化につながります。
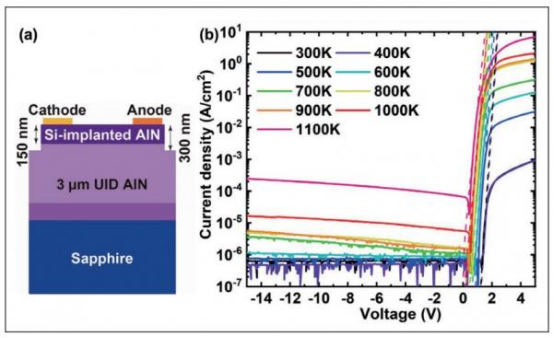
図 4. (a) シリコンが注入された AlN チャネルを備えたショットキー バリア ダイオードの断面図。 Ni/Au アノードと Ti/Al/Ti/Au カソード。 (b) 27 °C ~ 827 °C での AlN ショットキー バリア ダイオードの電流密度-電圧特性。
MIT、アアルト大学、TNSC、DOWA エレクトロニクス マテリアルズとの共同研究により、AlN 中のシリコン、酸素、マグネシウム原子の拡散を調査しました (図 3 を参照)。調査の結果、厚さ 3 μm の AlN 層を使用すると、アニール後にサファイア基板から拡散する酸素原子がチャネル層に到達できないことがわかりました。このことから、シリコンとマグネシウムのインプラントを含む導電性 AlN 層の好ましいアニール温度範囲は、それぞれ 1200 ~ 1600 °C と 1400 ~ 1500 °C であるという結論に至りました。この知識により、最初の AlN チャネル トランジスタを実証することができました。
デバイスの製造にエピタキシャル成長や高温アニーリングなどの熱平衡に近い条件が含まれる場合、250 ~ 320 meV のイオン化エネルギーを持つ深い状態の形成が促進されます。これはシリコンドナーの自己補償につながる傾向があり、我々の結果と一致する状況です。
一方、イオン注入などの非平衡プロセスを使用すると、イオン化エネルギーが 64 ~ 86 meV の浅いドナーの数を増やすことができます。このため、ノースカロライナ大学と Adroit Materials の Hayden Breckenridge 氏らは、シリコン注入と 1200°C の比較的低い温度でのポストアニーリングによって、高導電性の AlN 層を生成しました。京都大学から得られたもう一つの心強い結果は、AlN の置換マグネシウム-アクセプター結合エネルギーがわずか 250 ~ 410 meV であり、一般的な MOCVD 成長 AlN 層におけるマグネシウムアクセプターのイオン化エネルギーよりもはるかに小さい値であるということです。総合すると、これらの結果は、シリコンとマグネシウムをドープした AlN で非平衡プロセス条件を再現可能かつ容易に制御できれば、性能が大幅に向上した電子デバイスや光学デバイスへの扉が開かれる可能性があることを示しています。
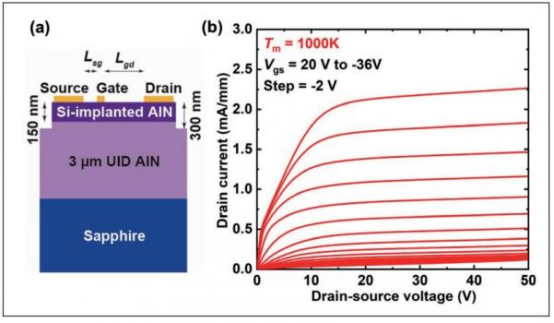
図 5. (a) シリコン注入 AlN チャネルを備えた MESFET の概略断面図。 (b) 727 ℃におけるAlN MESFETのDC出力特性。
AlNの電気的性質
AlN ベースのデバイスの電気的性能を向上させるには、キャリア濃度が低いことで損なわれる n 型および p 型 AlN 層の高抵抗率に対処するだけではなく、やるべきことはたくさんあります。さらに、電子親和力が小さいために生じる高い接触抵抗率にも対処する必要があります。
AlN において室温でオーム接触を形成することは特に困難です。電圧降下はショットキー障壁の高さによって決まり、これは金属の仕事関数と半導体の電子親和力の差に依存します。電極材料を適切に選択することでポテンシャル障壁の高さを下げることにより、オーミックコンタクトを形成することが可能です。 n 型 AlN のオプションはチタン、アルミニウム、バナジウム、モリブデンですが、p 型 AlN へのオーミックコンタクトにはパラジウムと NiO を使用できます。
半導体材料における高濃度ドーピングの影響の 1 つは、空乏領域の幅が減少し、ポテンシャル障壁を通過するトンネリングにつながることです。最上部の AlN 表面の高濃度ドーピングは、オーム接触にとって非常に重要です。ただし、AlN 層内のシリコンとマグネシウムのドーパントの濃度は約 10 に制限されているため、19 cm-3おそらく補償欠陥の形成のため、電界放出トンネリングの見通しはありません。
半導体構造内のキャリア濃度とキャリア移動度を決定するために、研究者はホール効果測定に頼る傾向があります。これらの測定にはオーム挙動が必要であるため、一部の研究では高濃度にドープされた GaN コンタクト層が使用されています。これにより、室温と高温の両方で AlN の電気的特性を測定できるようになりました。他のものと同様に、高温でのキャリア濃度とキャリア移動度を評価し、それぞれ 200 °C と 500 °C を超える温度での n 型と p 型 AlN の値を得ました。
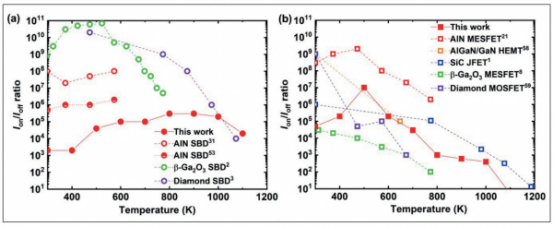
図6. AlNデバイスの電流オンオフ比と測定温度を他の最先端の(a)ショットキーバリアダイオードおよび(b)FETと比較したベンチマークプロット。
この研究を行った際、高温測定に関連する新たな問題が判明しました。極端な温度に対応するボンディング技術やパッケージ技術がなかったため、プローブ ステーションを使用する必要がありました。また、通常のプローブチップは高温で劣化することもわかりました。報告されているほとんどのデバイスの最大動作温度は 500°C 以下であることに注意してください。これは、これより高い温度では電気的特性の測定の信頼性が低いことを意味します。
DOWAエレクトロニクスマテリアル社と共同で、高真空中で最高測定温度900℃の高温プローブシステムを用いて、サファイア基板上の厚さ3μmのAlN層の電気特性を評価しました。この取り組みでは、n 型コンダクタンスを得るために室温で AlN 層にシリコンを注入しました。濃度は2×10でした19 cm-3 深さ150 nmのボックスプロファイルで。これらのシリコンが注入された AlN 層は、その後 1500°C でアニールされました。次に、950°C で焼結する前に、オーミックコンタクト用の Ti/Al/Ti/Au 電極を堆積しました。
おそらく Ti/Al と AlN の間の反応により、電極は 877°C で劣化しました。このため、当社は極端な温度でのオーム接触に適した金属を探すことになりました。考慮することができた温度では、127 °C 未満では非線形、227 °C を超えるとほぼ線形となる電流と電圧の関係が観察されました。 227 ℃から827 ℃の間で電気特性を評価すると、温度の上昇とともにシート抵抗と接触抵抗が減少することがわかりました。 227 ℃から627 ℃まで、温度が上昇するにつれて電子移動度はわずかに低下しましたが、ドナーのイオン化が促進されたため電子濃度が増加し、その結果高温でのシート抵抗が減少しました。このことから、n 型 AlN 層は極端な温度でも優れた性能を発揮するとの結論に至りました。
ダイオードとトランジスタ
我々は、サファイア基板上にシリコン注入されたAlN層を備えたショットキーバリアダイオードとMESFETを作製しました。当社のダイオードは、これまでの記録をすべて上回る 827 °C で動作することができ (図 4 を参照)、トランジスタは最大 727 °C で動作することができます (図 5 を参照)。 AlN ショットキー バリア ダイオードのブレークダウン電圧は室温で 610 V ですが、AlN MESFET の 727 °C での対応する値は 176 V です。これらのデバイスは、単純な特性を備えているため、実際に実現可能であることを強調したいと思います。 AlN 層は大型で低コストのサファイア基板上に成長します。
ショットキー バリア ダイオードと MESFET を製造するために、アノードとゲートのコンタクトに Ni/Au を使用しました。ニッケルは熱的に安定であり、827 ℃でもAlNとほとんど反応しないことがわかりました。さらに、電気的特性に関しては、Ni/Au と Pt/Au の間にほとんど差がありませんでした。ショットキーバリアダイオードの場合、真性キャリア濃度が低いことと熱的に安定した Ni/AlN 界面により、827°C であってもオフ電流は小さくなります。ただし、AlN MESFET のオフ状態のドレイン電流は、底部のアンドープ AlN 層を通るリークと高濃度の欠陥により、727°C では高くなります。フォノン散乱により高温で低下するシリコンデバイスの電流とは異なり、AlN ショットキーバリアダイオードと MESFET の順電流は 827°C まで温度とともに増加し続けることを発見しました。これは、極端な温度における AlN デバイスの電流が電子濃度の増加と接触抵抗率の低下によって支配され、電子移動度の低下が二次的な役割を果たすためであると考えられます。
当社の AlN デバイスの開発は、極端な温度でも動作できる半導体デバイスを製造するための新しい道を切り開いています。ショットキー バリア ダイオードおよび FET のオンオフ比と温度の間にはトレードオフがありますが (図 6 を参照)、AlN デバイスには改善の余地がたくさんあります。たとえば、ホモエピタキシャル成長と JFET 構造の導入を組み合わせることにより、極端な温度でのオン/オフ比を高めることが可能になるはずです。 Ti/Al/Ti/Au ではなく、耐熱性のオーム接点の導入によってさらなる改善がもたらされる可能性があり、これにより動作温度が 877°C 以上に上昇します。
ほとんどの極端な温度アプリケーションでは、IC が長期間にわたって確実に動作する必要があります。このような回路は、n チャネルと p チャネルを備えた相補的な技術で製造されます。京都大学のエンジニアは、350°C で動作する SiC 相補型 JFET ロジック ゲートを開発しました。私たちは、同様の方向に研究を進め、極限環境で動作可能なホモエピタキシャル AlN チャネルを備えた相補型 JFET を製造したいと考えています。
筑波大学 奥村洋則氏より
から https://compoundsemiconductor.net/article/118570/Extreme-temperature_devices_using_AlN
私たちのサービスが必要な理由は、プロジェクトが適切に行われ、機能することを確認するための専門知識と経験を持つ、高度な資格を持つ専門家を獲得していることを知っているからです。
無料相談をご希望の場合は、フォームに記入して開始してください:
受信トレイでセール情報、ニュース、アップデートを受け取ります。
 闽ICP备19012761号-1
闽ICP备19012761号-1



